|
Banc
de recherche pour le
test des semi-conducteurs.
Le Challenge:
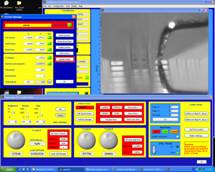 Le
test des semi-conducteurs sur tranche de silicium (wafer) nécessite
d'établir un contact électrique avec les circuits gravés sur la plaque.
Ce contact est établi physiquement via ce que l'on appelle une "carte
à
pointes". Le
test des semi-conducteurs sur tranche de silicium (wafer) nécessite
d'établir un contact électrique avec les circuits gravés sur la plaque.
Ce contact est établi physiquement via ce que l'on appelle une "carte
à
pointes".
Une carte à
pointe est un ensemble de pointes de quelques dizaines de micromètres de
diamètre qui sont solidaires les unes des autres et qui sont disposées
suivant une configuration propre au circuit à
tester.
Chaque fois qu'un contact
électrique est établi entre les pointes de la carte à
pointes et les pads de connexion des circuits, une fraction du matériau
constituant ces pads est arraché, polluant ainsi les pointes et la
plaque de silicium par des débris de matière. Ces débris de matière
s'accumulent sur les pointes et finissent par dégrader la qualité du
contact électrique (Rcontact).
Afin de garder les
pointes propres et d'éviter au mieux la pollution de la plaque par des
débris de matière les pointes doivent être régulièrement nettoyées en
les insérant dans un matériau abrasif retenant les débris. La résistance
de contact retrouve alors une valeur faible.
Si les pointes ne sont
pas nettoyées assez régulièrement le rendement des puces bonnes sur la
plaque chute car des circuits sont alors rejetés à tort. Si le nettoyage
a lieu trop souvent le temps de test et l'usure des cartes à pointes
augmente ce qui augmente le coût du test. Il convient donc de déterminer
la fréquence de nettoyage optimale des pointes de test. Celle-ci peut
varier dans de grandes proportions en fonction des matériaux
constituants les pads et les pointes de test mais aussi en fonction des
procédés de fabrication des circuits.
Afin d'optimiser
rapidement les paramètres de nettoyage des pointes de test et d'étudier
les interactions entre les pointes et les pads de test d'une part et les
interactions entre les pointes et les matériaux de nettoyage d'autre
part il fallait construire un banc permettant de simuler le test des
semi-conducteurs et permettant la mesure des paramètres dont l'accès
n'est pas possible sur une chaîne de test en production.
Le matériel:
- Un capteur de force
Transducer Techniques relié à
une carte d'acquisition
National Instruments permettant de mesurer la
pression de la pointe sur le pad de test. Le capteur de force est
lui-même solidaire d'un actionneur en Z permettant de lever ou de
baisser la pointe sur le pad de test et d'effectuer ainsi des touchdowns.
- Un chuck régulé en
température (-100 a +400 degrés Celsius) fourni par
Instec. Le substrat
de silicium contenant les circuits à
tester est maintenu au chuck par vide d'air. Le chuck est monté sur une
table X-Y permettant de le déplacer et d'amener ainsi sous la pointe de
test les pads de test ou les matériaux de nettoyage.
- Un contrôleur d'axe
National Instruments PCI-7334 équipé d'une unité de puissance MID
7604 pour le contrôle des actionneurs X, Y et Z.
- Un
sourcemetre Keithley
K2400 afin de réaliser des mesures électriques en tension ou courant et
caractériser ainsi le Cres.
- Une camera vidéo haute
résolution reliée à une carte Firewire NI-IEEE 1394.
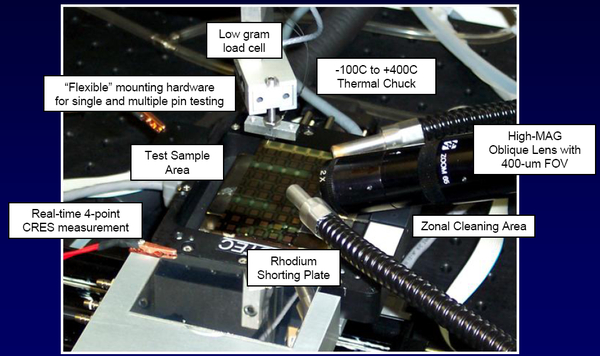
La solution:
- Un instrument de recherche
unique dans le domaine du test des semi-conducteurs avec une interface
logicielle implémentée en LabVIEW permettant de réaliser les fonctions
suivantes:
- Mesure de la force
nécessaire à
l'insertion des pointes de test dans les matériaux de nettoyage.
- Mesure de la résistance
de contact en fonction de la force appliquée à la pointe.
- Visualisation de
l'accumulation des débris sur les pointes en fonction du nombre de
touchdowns.
- Visualisation de
l'usure des pointes en fonction du nombre de touchdowns dans le matériau
de nettoyage.
- Simulation des
fonctions de probing
permettant de reproduire en laboratoire les conditions de test
rencontrées en production.
Pour en savoir plus sur
ce banc de recherche vous pouvez télécharger la présentation suivante
sur le site de l'IEEE
Semiconductor Wafer Test Workshop:
- "Novel
Methodologies for Assessing On-line Probe Process Parameters"
(J. Broz, B. Blanc, G. Humphrey, R. Moore, P. Mui)
- "Optimisation
des procédés de test des semi-conducteurs" (Brice Blanc,
Solutest)
|